
VPE由反应室和盖子组成。加热元件集成在盖子中。它控制要蚀刻的基板的温度。可以通过两种方式实现晶圆夹紧:可以使用夹紧环将晶圆机械夹紧。拧紧是从设备的背面完成的,该设备永远不会与HF蒸气接触。3个螺母易于戴上防护手套。另一种选择是静电夹紧。单个芯片(长于10毫米)以及晶片都可以被夹在加热元件上。保护晶片的背面不受蚀刻。
液态HF被填充到反应室中。反应室用盖封闭。HF蒸气在室温下产生,蚀刻过程自发开始。蚀刻速率由可在35°C至60°C范围内调整的晶圆温度控制。
加工后,酸可储存在储罐中,以在密封容器中重新使用。只需通过用手柄降低连通的储液罐即可完成液体传输。由于重力,酸流入容器中,并可以通过两个阀关闭。通过打开阀门并提起手柄来完成对反应室的填充。酸流入反应室。酸可以重新用于多次蚀刻,直到必须更换为止。
VPE系统占地面积小,可以轻松集成到现有的流量箱中。
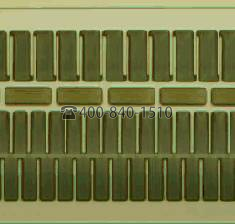
MEMS的粘着
二氧化硅通常用作微机械结构的牺牲层。例如,绝缘体上硅(SOI)晶片上的深反应离子蚀刻(DRIE)器件通常在液态氢氟酸(HF)中释放。
用去离子水冲洗晶片后,水的表面张力破坏了释放的结构或结构彼此粘附。
应用
-免粘MEMS释放
-结构减薄
-SOI衬底上结构的无划片释放
-蚀刻速率可在0至约30 µm / h之间调节
-单面SiO2蚀刻(在处理过程中受到背面保护)
光学MEMS的无切割释放:智能双面深反应离子刻蚀可在晶片级上实现无丁片切割
结构细化:连续氧化和HF VPE可以制造亚微米直径的扭力梁
光子带隙:薄牺牲层上的纳米膜可以轻松释放
岛结构:定时蚀刻允许制造仅被剩余的SiO2悬浮的岛状结构(明亮)。较暗的结构被释放。
薄膜应用:在1 µm的热SiO2上释放的0.5 µm厚的多晶硅光束:光束的宽度为10 µm,长度在100到500 µm之间变化
小孔的蚀刻率:孔被干法蚀刻到0.5 µm的多晶硅中,该多晶硅沉积在1 µm的热SiO2上。牺牲SiO 2的蚀刻速率取决于开口的直径。小开口既没有粘附也没有“不良润湿”(液体不会扩散到小孔中)。
铝结构:可以释放SiO2上的铝结构。铝悬臂中的高应力会导致强烈的卷曲。将0.5 µm厚的铝层沉积在1 µm热SiO2上。

反应室温度控制
二氧化硅的蚀刻速率随反应室中液态HF的温度而略有变化。HF的温度取决于洁净室的环境温度。另外,HF在长时间的蚀刻过程中加热,这导致晶片之间的蚀刻速率增加,直到系统稳定为止。为了稳定刻蚀速率,我们在容器中开发了一个具有可控温度的HF反应室。HF的温度可以通过附加控制器进行调节。珀耳帖元件可根据所需的工艺参数来加热或冷却酸。


