idonus 氢氟酸(HF)蒸汽相蚀刻(VPE)系统是一种洁净室微加工设备。HF蒸汽通过热控蚀刻二氧化硅层,实现无粘附释放微机电系统(MEMS)。
idonus 提供多种氢氟酸(HF)蒸汽相蚀刻(VPE)产品。HF VPE(以下简称VPE)基于HF酸的化学反应,能够选择性蚀刻二氧化硅(SiO₂),而硅(Si)保持完好。标准VPE适用于不同直径的晶圆,包括100 mm、150 mm 和 200 mm。
1. 产品概述
idonus 氢氟酸蒸汽相蚀刻(VPE)设备用于洁净室微加工设施,实现**无粘附(stiction-free)**的二氧化硅(SiO₂)蚀刻。VPE 产品适用于 100 mm、150 mm 和 200 mm 的晶圆,并提供适用于更小晶圆或单个芯片的夹持解决方案。
VPE 设备可安全释放微结构器件,尤其是具有微小间隙或易碎悬浮梁的器件(如梳状驱动器、AFM 探针)。这些结构常见于微机电系统(MEMS)中。由于液态 HF 酸的内聚力可能破坏微小结构或导致其永久粘附,因此传统液态 HF 酸无法用于此类工艺。而 VPE 采用 HF 酸蒸汽相蚀刻,使这些微结构可以无粘附释放。
优点
- 安全处理HF酸
- 可重复使用的HF酸
- 简便的晶圆夹持机制
- 适用于所有晶圆尺寸
- 无需额外安装:设备可直接用于酸性湿法工艺平台
- 晶圆反向蚀刻
- 背面保护
- 低运行成本
2. 蒸汽相 HF 的应用
HF 酸广泛用于 MEMS 设备中选择性蚀刻 SiO₂。通常,在绝缘体上硅(SOI)晶圆中,SiO₂ 层既用作电气绝缘层,也可作为牺牲层以释放 MEMS 微结构。
在HF 酸蒸汽环境中蚀刻是一种准干法工艺,通过受控加热基板,可以调节晶圆上的 HF 酸蒸汽量,从而以可重复的方式控制 SiO₂ 的蚀刻速率。
由于晶圆不与液体直接接触,VPE 设备可以实现高产率的无粘附 MEMS 释放。采用 HF 蒸汽相蚀刻 SiO₂ 的典型速率在 4 – 10 μm/小时 之间。
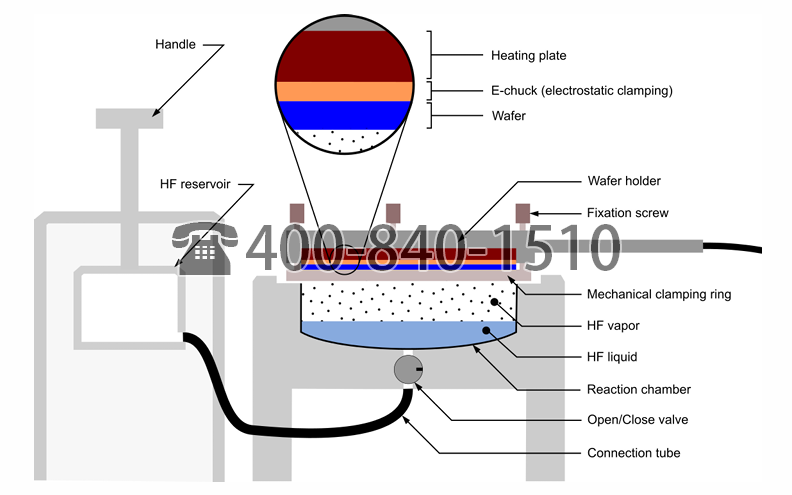
3. 产品描述
VPE系统由反应室和晶圆夹具组成。加热元件集成在晶圆夹具中,用于控制待蚀刻基板的温度。晶圆夹持有两种方式:机械夹持或静电夹持。在这两种方式中,基板的隐藏面都能得到保护,避免被蚀刻。
- 晶圆可以通过夹紧环进行机械夹持。夹紧环通过晶圆夹具的背面进行螺栓固定,背面从不与HF蒸气直接接触。三个大聚合物螺丝便于佩戴防护手套时操作。
- idonus提供了可选的静电夹持机制。可以夹持单个芯片(至少5毫米宽)或完整晶圆到加热元件上。这种方案的优点是避免了机械夹持造成的应力集中。
一旦基板被夹持在晶圆夹具上,反应室可以充满液态HF。然后,用晶圆夹具封闭反应室。HF在室温下蒸发,蚀刻过程自动开始。蚀刻速率通过调整晶圆的温度来控制,温度可调范围为35°C至60°C。
HF酸可以用于多次蚀刻。为此,HF储液槽用于暂时储存HF液体,供基板交换时使用:在处理完一个晶圆后,反应室中的酸液可以流入可密封的HF储液槽。HF液体转移通过降低HF储液槽的手柄来简单完成。通过连通容器,酸液流入HF储液槽,并可以通过手动阀门关闭。重新填充反应室时,只需转动阀门并提升手柄,酸液即可流回反应室。
VPE系统占地面积小,可以轻松集成到现有的流箱中。
4、可选配置
4.1. 多芯片静电夹具
静电夹具能够通过静电力将多个芯片或晶圆的部分夹持在晶圆夹具上。该设备在研发原型制作中非常有用,因为在某些情况下无法处理完整的晶圆。芯片的静电夹持使得可以在HF蒸气释放之前对MEMS晶圆进行严苛的切割过程。通过修改传统的制造流程,可以生产出具有极软悬挂结构的MEMS设备。
使用静电夹具非常简单。将芯片放置在晶圆夹具上,然后通过控制单元上的开关打开静电力。静电力可以调节。
4.2. 晶圆夹具安全网和适配环
安全网是抗HF的网状物,放置在反应室内(见图6)。其目的是捕捉未附着在晶圆上的释放部件。HF会在网状物上凝结。因此,操作时必须戴上防护手套。150mm和200mm晶圆夹具的适配环可以用于适配更小的晶圆尺寸。
4.3. 反应室温控
二氧化硅的蚀刻速率随着反应室中液态HF的温度变化而变化。HF的温度取决于洁净室的环境温度。此外,长时间的蚀刻过程中HF会加热(放热反应),导致蚀刻速率从晶圆到晶圆逐渐增大,直到系统稳定为止。
5、应用
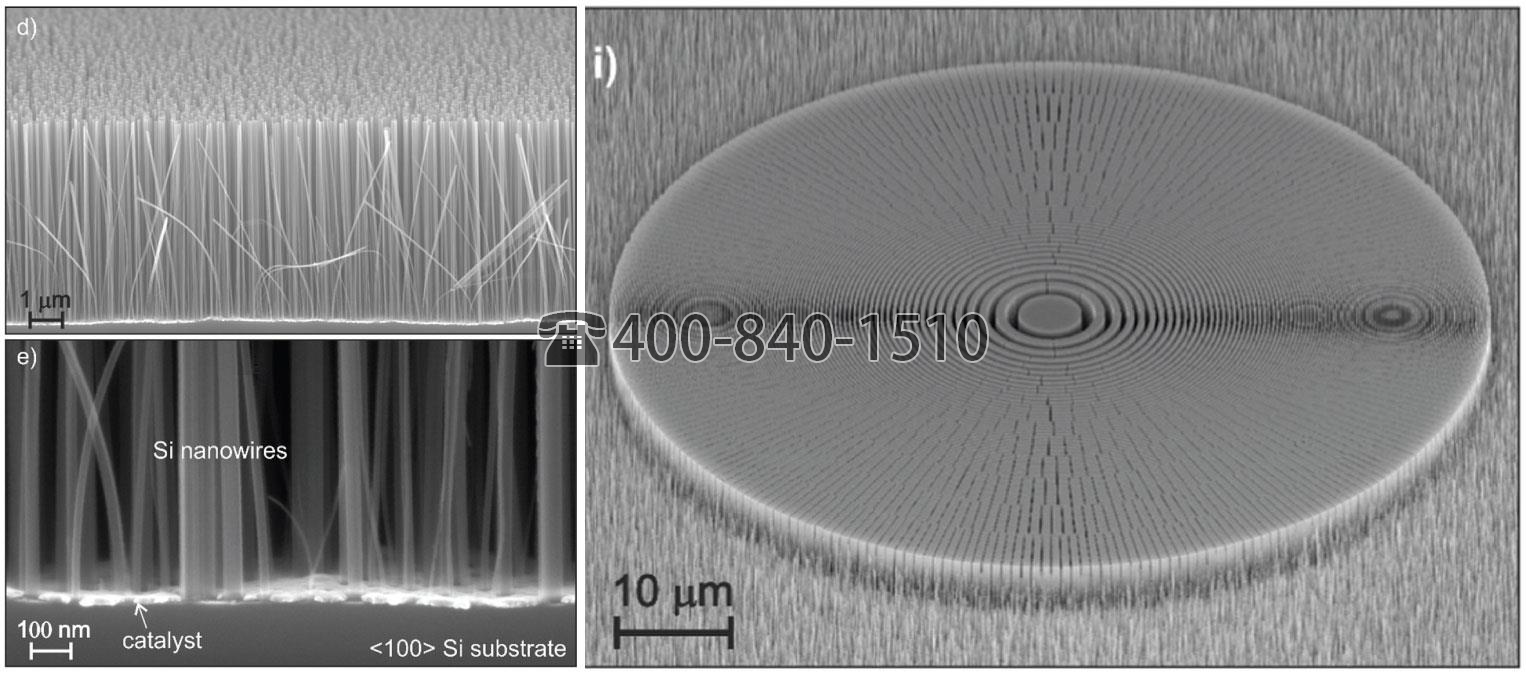
|
|
|
|
|
|