RCH 炉系统
RCH Associates 的炉子设计旨在实现最佳的温度精度和稳定性。炉体封装在一个整体化、坚固且具有良好热绝缘的机柜结构中,最多可配置 4 根加热元件,便于维护并延长使用寿命。利用我们专有的 ASTRA 控制系统,RCH 炉可为操作员提供最大的精确性和易用性,并配备全面的自动化和数据记录工具,以确保工艺的一致性。大多数 RCH 扩散和 LPCVD 工艺均提供保证的工艺性能标准(晶圆内均匀性、晶圆间均匀性等)。
RCH 拥有数十年的经验,可为多种应用定制各种炉系统,包括:
水平扩散炉(2 至 4 根管,适用于 75-300mm 直径晶圆)
干氧化
干氧化(HCl 增强)
干氧化(DCE 增强)
无氢湿氧化(使用 RCH Steamer™)
灰烬氧化,内置火炬
灰烬氧化,外置火炬
灰烬氧化(HCl 增强)
灰烬氧化(DCE 增强)
DI:H2O 气泡氧化
POCl3 液体源掺杂(磷掺杂)
BBr3 液体源掺杂(硼掺杂)
固体源掺杂
氢气退火/合金化
成形气退火/合金化/烧结
惰性气体或贵气体退火/合金化/烧结
水平 LPCVD 炉(最多 4 根管,适用于 75-200mm 直径晶圆)
本征多晶硅
非晶硅
磷掺杂多晶硅
SiPOS(氧掺杂多晶硅)
氮化硅(Si3N4)
低应力氮化硅
氧氮化物
高温氧化硅(HTO)
低温氧化硅(LTO)
磷硼硅玻璃(PSG)
硼磷硅玻璃(BPSG)
四乙氧基硅烷(TEOS)
掺杂 TEOS
真空退火系统(快速冷却,适用于 100-150mm 晶圆)
RCH Associates 设计的 VAF 炉系统用于对对残余氧敏感的基板薄膜(如难熔金属和复合金属)进行退火、合金化或烧结。
该系统包括一个沿主真空工艺腔外部移动的加热元件。
这一独特设计允许在真空状态下快速加热和冷却工艺腔。
小批量系统(适用于 50-200mm 直径晶圆)
适用于 50-150mm 晶圆的台式炉
适用于 150-200mm 晶圆的台式炉
独立式单管或双管 RCH 炉,适用于 50-150mm 晶圆
RCH 炉系统设计特点
炉体机柜
整体化结构钢组装
带铰链、锁定且可拆卸的加热元件检修门
具有热绝缘的外壳面板
高温聚氨酯涂层
易于调节的加热元件支撑装置
机柜过温联锁传感器
调平支脚及可选抗震支架
有毒气体排放装置(Toxic Gas Scavenger)
不锈钢材质
排放来自工艺管或工艺腔的废气和热量
每根管道级可独立调节排气抽吸量
每管级可采用悬臂式封闭或手动门封闭
LPCVD 法兰及气体管路安装方案
差压表用于监控排气抽吸量
风冷-水冷换热器(Air-To-Water Heat Exchanger)
用于排出炉体顶部的热空气
控制炉房的暖通空调(HVAC)
水冷高效散热器
导流挡板将空气引导通过炉体
排气风扇模块用于空气抽排
高性能加热元件(High Performance Heating Elements)
可选温度范围:350°C 至 1350°C
600-1350°C 温区,温度公差 ±0.5°C
350-600°C 温区,温度公差 ±1.0°C
真空成型高纯度氧化铝绝缘
不锈钢护罩
螺旋绕组,带固定间距
每区温控及过温热电偶(TC)监控
封闭式热电偶导线槽
热电偶固定和校正夹
能量套件(Energy Kits)
高纯度氧化铝前室块(vestibule blocks)
NEXTEL 软护圈
不锈钢固定环、板和护圈
4 层水平 LPCVD 炉(适用于 200mm 晶圆)
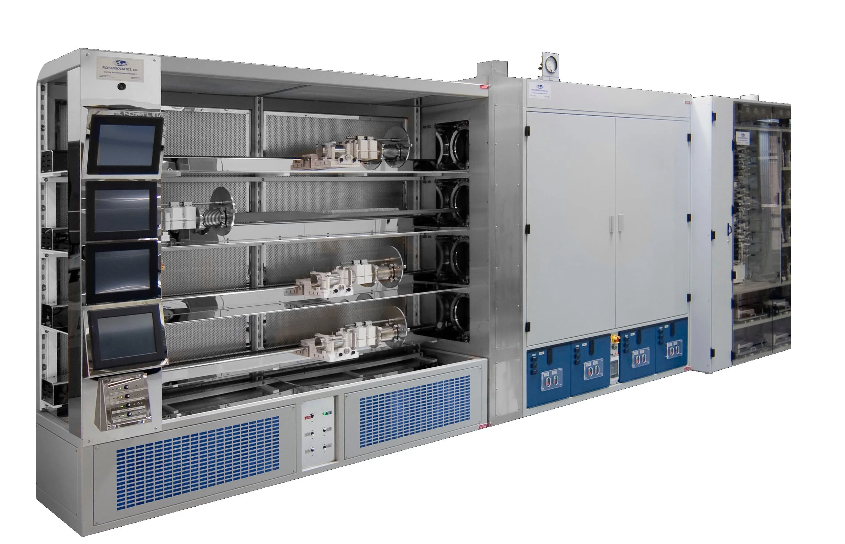
3 层真空退火炉(适用于 150mm 晶圆)
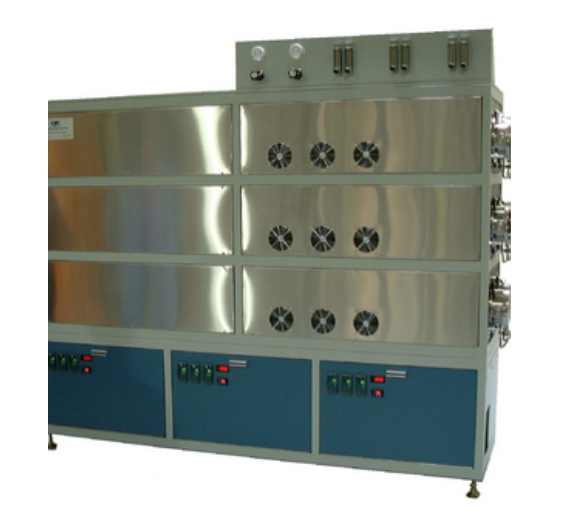
2 层水平扩散炉(适用于 300mm 晶圆)


https://www.bihec.com/rchassociates/进口代理RCH Associates水平扩散炉/水平 LPCVD 炉,RCH 炉系统/