我们针对多组分材料研究中对更高通量需求的解决方案:多束溅射沉积。
这是一种基于离子束溅射的独特薄膜沉积几何结构,通过我们超紧凑且超低功耗的电子回旋共振(ECR)技术产生多束离子束。一个关键特性是,使用非常紧凑的溅射靶材,能够在固定的基底上实现成分和厚度的均匀沉积,或者进行可控梯度的沉积。这一切都集成在一个高度自动化且占地面积极小的系统中。
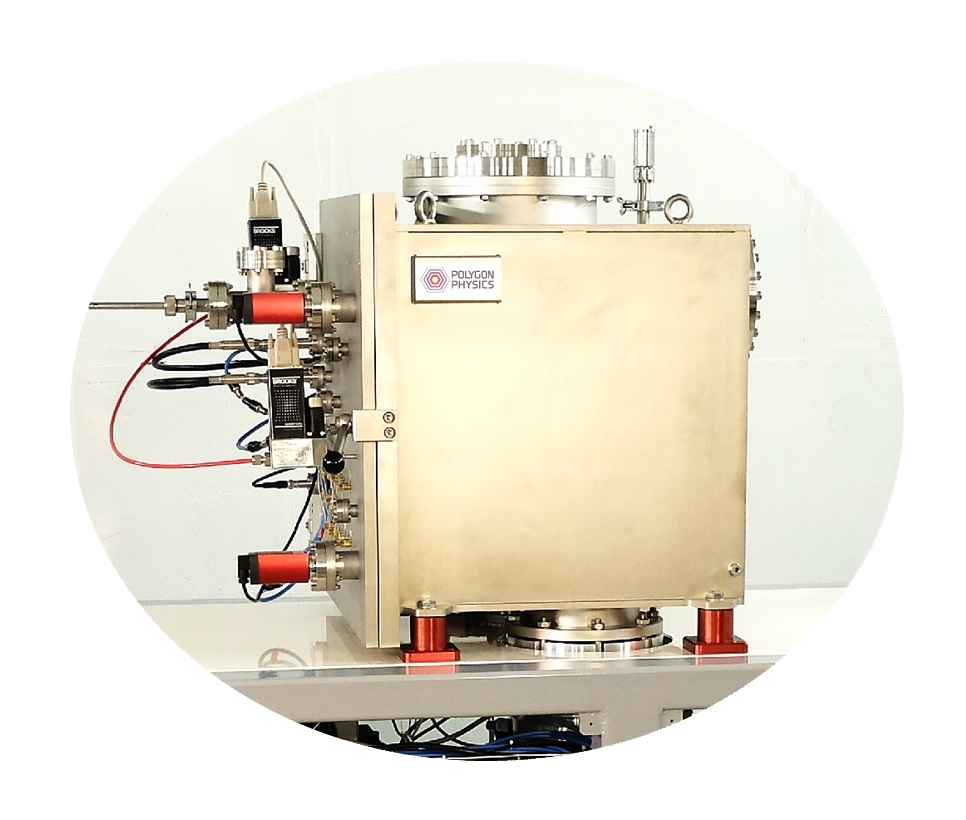
离子束沉积 “轻松实现”
通常认为,用于离子束沉积的系统体积庞大且复杂。而我们的多束沉积系统试图打破这一观念。我们相信,由于我们系统的概念完全不同,如今离子束沉积可以 “轻松实现”。
可调节的沉积参数:在大电流和能量范围内实现稳定的离子束
易于系统操作:本质可靠的离子源类型以及便捷的用户界面
低系统维护:采用专利设计,保护离子源和反应腔免受沉积影响
动一个工艺,该系统能够基于多达 24 个(取决于源的数量)独立靶材沉积几乎任何固体靶材材料的薄膜。例如,除了用于源操作的惰性气体之外,还可以通过在样品附近使用第二种气体来进行氮化物或氧化物薄膜的反应性沉积。
我们的方法与传统离子束溅射沉积方法一样 “对样品友好”:衬底可以是敏感材料,因为它们不会受到等离子体的侵蚀(等离子体被限制在源腔中),无需对样品进行偏压,并且样品加热极小。
我们的系统所制备的薄膜质量是离子束溅射沉积的典型质量。薄膜致密且光滑,通常为纳米晶性质,并且不含有(来自源的)惰性气体。我们系统的非标准几何结构能够实现半共形沉积。
多种类型的多组分薄膜
我们沉积系统所采用的源技术为多组分薄膜的制备提供了巨大的可能性。
首先,这是因为我们的电子回旋共振(ECR)离子源在束流和能量方面都有较大的操作窗口。其次,每个离子源都通过独立的射频电源进行单独控制。最后,这些离子源易于单独开启和关闭。这不仅能够实现多组分材料的均匀沉积,还能对非均匀多组分材料的沉积进行控制。对于旨在快速发现新材料的组合薄膜合成而言,衬底上的非均匀成分分布可能具有重要意义。从垂直方向上的非均匀成分分布,例如,对于改善薄膜在衬底上的附着力,或者创建连续变化的折射率可能会很有用。
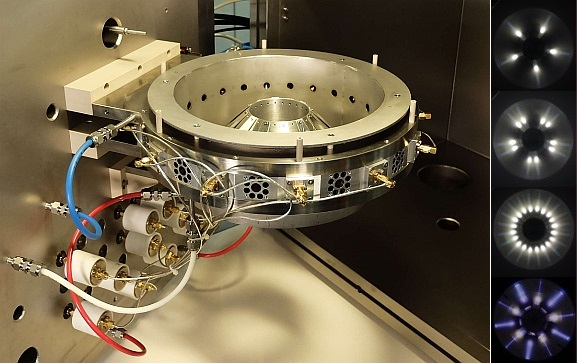
合金与化合物沉积:在整个成分范围内控制化学计量比
功能梯度薄膜:在工艺过程中改变单个源的沉积速率和 / 或能量
多层沉积:通过单独打开和关闭源来制备多层薄膜
系统规格(MBS – 24)
・50x50x50 厘米真空室
・直径 32 厘米源环
・多达 24 个离子源(独立射频电源)
・每个离子源 0 – 500 微安
・5 – 10 千伏离子束能量
・油冷(源环和靶材)
・罗茨泵 15 立方米 / 小时,涡轮分子泵 700 升 / 秒
・源气体入口:如氩气(Ar)、氙气(Xe)
・工艺沉积
・实时自动束流调谐
・可定制样品(顶部)装载
・在直径 10 厘米(静态)上,70 纳米 / 小时的均匀性为 ±2%
・多达 4 种成分的均匀薄膜
・反应气体入口:如氧气(O2)、氮气(N2)
・薄膜厚度监测

