多束溅射沉积系统
针对多元材料研究中对高通量需求的创新解决方案:多束溅射沉积技术。基于离子束溅射的独特几何结构设计,搭配我们超紧凑、超低功耗的ECR技术生成的多重离子束。其核心特点是能在静态基板上实现成分与厚度均匀的沉积,或通过紧凑型溅射靶材实现可控梯度沉积。整套系统高度自动化,占地面积极小。
MBS-24系统图示:50×50×50厘米沉积系统,配备24个独立离子源,可制备Ø10厘米范围内均匀性达±2%的(多元)薄膜
“化繁为简”的离子束沉积
传统离子束沉积系统通常被认为体积庞大且操作复杂。我们的多束沉积系统旨在颠覆这一认知。凭借全新的设计理念,离子束沉积如今可以变得简单易行。
▌可调沉积参数
在大电流与宽能量范围内保持离子束稳定
▌简易操作系统
高可靠性离子源搭配友好用户界面
▌低维护需求
专利设计保护离子源与腔体免受沉积污染
只需启动预设方案,系统即可利用最多24个独立靶材(根据离子源数量)沉积几乎所有固态靶材薄膜。除离子源工作所需的惰性气体外,通过在样品附近通入反应气体(如氮气或氧气),还可制备氮化物或氧化物等反应沉积薄膜。
我们的技术对样品极为友好,与传统离子束溅射沉积相同:基板可选用敏感材料,因其不受等离子体侵蚀(等离子体仅存在于离子源腔内),无需偏压且温升极低。
系统沉积的薄膜具有典型离子束溅射特性:致密光滑,多呈纳米晶态,且不含离子源惰性气体。特殊几何结构还能实现半保形沉积。
多元薄膜的无限可能
我们的ECR离子源技术为多元薄膜制备提供了广阔空间:
离子源具备宽泛的束流和能量调节范围
每个离子源通过独立射频电源控制
可单独快速启停离子源
这不仅支持均匀多元材料沉积,还能精确调控非均匀组分分布——横向组分梯度适用于组合材料高通量筛选,纵向梯度则能优化薄膜附着力或制造渐变折射率材料。
▌合金与化合物沉积
全成分范围内精确控制化学计量比
▌功能梯度薄膜
动态调节各离子源沉积速率及能量
▌多层膜沉积
通过独立启停离子源构建多层结构
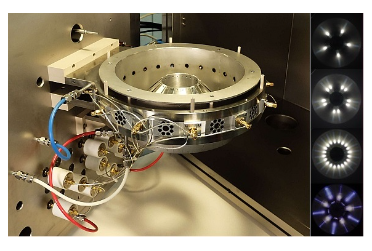
系统规格(MBS-24)
50×50×50厘米真空腔体
Ø32厘米离子源环
最多24个离子源(独立射频电源)
单离子源0-500μA束流
5-10kV离子束能量
油冷系统(源环与靶材)
15m³/h罗茨泵+700l/s涡轮泵
工作气体:如Ar、Xe
预设方案沉积
实时自动束流调节
可定制样品(顶部)装载
Ø10cm静态沉积70nm/h时均匀性±2%
最多4组分的均匀薄膜
反应气体入口:如O₂、N₂
膜厚监控仪




