HiPIMS —— 高功率脉冲磁控溅射技术
高功率脉冲磁控溅射(HiPIMS)是磁控溅射领域一项较新的技术进展。该技术采用特殊设计的电源,通过产生极高能量、短时脉冲来激发高密度等离子体放电。与传统磁控溅射中镀膜材料大多保持中性不同,HiPIMS能使绝大部分溅射原子电离。电离后的粒子流可通过电磁场引导,从而实现对镀膜性能的更精准调控。

在HiPIMS工艺中,通过向溅射靶材施加高峰值电压与高电流密度脉冲实现溅射,其脉冲持续时间较短(通常为50-200微秒)、频率较低(约500赫兹),而脉冲间隔可短至百分之几秒。这种低占空比设计(约10%)在维持工艺稳定性的同时,能有效减少热效应。
采用HiPIMS技术可显著改变薄膜的形貌与结构,从而优化多项性能指标。通过该工艺,薄膜的致密性、硬度、表面形貌、折射率及附着力等特性均可得到定向调控与增强。
美国Angstrom开发了可承受极高功率密度并适用于连续长周期生产应用的溅射阴极系列。结合专利湍流靶材冷却技术, 美国Angstrom的高功率脉冲磁控溅射阴极还在阳极体与安装法兰中设计了辅助冷却流道,确保工艺运行中的最佳冷却效果。
其他特色包括采用被动与主动复合磁体阵列,使靶材表面磁场强度在其使用寿命内保持稳定——这对HiPIMS工艺中抑制电弧放电、实现溅射材料的最优电离至关重要。这些特性与坚固的阳极结构相结合,保障了HiPIMS及其他高功率长周期运行场景下性能的一致性与可重复性。
美国Angstrom的HiPIMS磁控管提供多种环形、线性及圆柱形设计选择。
我们还提供Plasus EMICON FS系统,这是一套快速光谱电学监测系统,可为HiPIMS或脉冲直流溅射等脉冲等离子体工艺提供连续的脉冲级过程监控与调控。凭借其前所未有的时间分辨率,EMICON FS系统树立了工业过程控制领域全球独创的新标准。
 ONYX-4 HiPIMS等离子体放电演示
ONYX-4 HiPIMS等离子体放电演示
 ONYX-2 HiPIMS磁控管(带挡板与交叉污染屏蔽装置)
ONYX-2 HiPIMS磁控管(带挡板与交叉污染屏蔽装置)
 ONYX-520 HiPIMS磁控管
ONYX-520 HiPIMS磁控管
 ONYX-1 HiPIMS磁控管(集成微型柔性适配模块)
ONYX-1 HiPIMS磁控管(集成微型柔性适配模块)
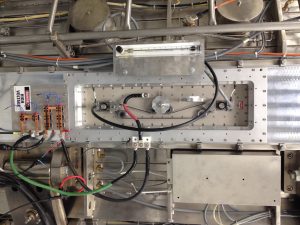 ONYX-330 HiPIMS磁控管(配备手动可调磁体阵列)
ONYX-330 HiPIMS磁控管(配备手动可调磁体阵列)
 ONYX-3 HiPIMS磁控管(搭载柔性组装系统)
ONYX-3 HiPIMS磁控管(搭载柔性组装系统)
 ONYX-559R圆柱形HiPIMS磁控管(ITO专用插入式设计)
ONYX-559R圆柱形HiPIMS磁控管(ITO专用插入式设计)
 ONYX-R圆柱形HiPIMS磁控管(侧装式,配备增强型磁体阵列)
ONYX-R圆柱形HiPIMS磁控管(侧装式,配备增强型磁体阵列)



