
Idonus HF气相蚀刻机VPE系列VPE100、VPE150、VPE200
HF气相蚀刻机VPE系列VPE100、VPE150、VPE200
VPE由反应室和盖子组成。加热元件集成在盖子中。它控制待蚀刻基板的温度。晶片夹紧可以通过两种方式实现:晶片可以通过使用夹紧环进行机械夹紧。拧紧是从设备的背面进行的,该背面永远不会与氢氟酸(HF)蒸汽接触。这3个螺母很容易用防护手套处理。另一种选择是静电夹紧。单个芯片(长度超过10毫米)以及晶片都可以夹在加热元件上。晶片的背面受到保护,免受蚀刻。
将液态HF填充到反应室中。反应室用盖子封闭。HF蒸汽在室温下产生,蚀刻过程自发开始。蚀刻速率由晶片温度控制,晶片温度可在35°C至60°C之间调节。
加工后,酸可以储存在储器中,以便在可密封的容器中重复使用。液体转移只需用手柄降低连通的储液器即可完成。由于重力作用,酸流入储液罐,可以通过两个阀门关闭。通过打开阀门并提起手柄来重新填充反应室。酸流入反应室。酸可以重复用于多次蚀刻,直到必须更换为止。VPE系统占地面积小,可以很容易地集成到现有的流箱中。
温控反应室(TRC)
二氧化硅的蚀刻速率随反应室中液体HF的温度略有变化。HF的温度取决于洁净室的环境温度。此外,HF在长时间蚀刻过程中会加热,导致晶片之间的蚀刻速率增加,直到系统稳定。
为了稳定蚀刻速率,我们有一个带有温度控制液体HF的反应室。HF的温度可以通过额外的控制器进行调节。将HF酸加热到阈值温度以上可以在蚀刻过程中保持温度稳定。

MEMS静摩擦
二氧化硅通常用作微机械结构的牺牲层。例如,绝缘体上硅(SOI)晶片上的深度反应离子蚀刻(DRIE)器件通常在液体氢氟酸(HF)中释放。在去离子水中冲洗晶片后,水的表面张力破坏了释放的结构或结构相互粘附。静摩擦的解决方案:含碘的HF蒸汽VPE
在HF蒸汽中蚀刻二氧化硅是一种准干法。由于HF蒸汽环境中的湿度,在晶片上存在非常薄的水膜。HF被吸收并蚀刻二氧化硅(SiO2).在反应过程中,产生硅烷和水。硅烷以气相形式逸出。有趣的是,在这个反应中,水起引发剂的作用,并且是由反应过程本身产生的。在加热衬底时,可以通过控制表面上的水量来调整蚀刻速率。在4-6微米/小时的蚀刻速率下,大多数结构可以被释放而不会粘连。蚀刻进度和均匀性如下图所示。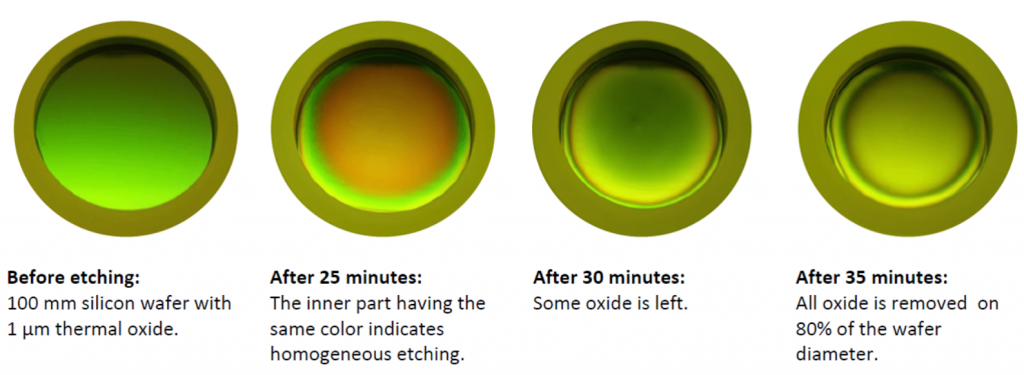
应用示例
- 无静摩擦MEMS释放
- 结构细化
- SOI衬底上结构的无切割释放
- 蚀刻速率可从0到约30微米/小时调节
- 单面氧化硅2蚀刻(加工过程中背面受到保护)


询价采购Idonus HF气相蚀刻机VPE系列VPE100、VPE150、VPE200
请用微信扫描下方二维码或手动添加微信号2351992198



