美国 MasterBond 高模具剪切强度胶水 Supreme 3HTND-2DA EP3HTS-TC EP3HTSDA-2 EP17HTDA-1 EP17HTDA-2
美国 MasterBond 高模具剪切强度胶水
Supreme 3HTND-2DA
EP3HTS-TC
EP3HTSDA-2
EP17HTDA-1
EP17HTDA-2
剪切测试对于评估粘合剂在表面安装和芯片粘接应用中的可靠性至关重要。在Master Bond,我们的粘合剂由独立实验室进行剪切剥离强度分析。测试基于Mil-Std-883标准的2019方法。剪切测试的主要目的是评估半导体芯片与封装基板之间的粘合强度。在此测试中,力以垂直于芯片边缘且平行于芯片粘接或基板平面的方向施加。

我们用于测试的化合物是单组分导电和非导电环氧树脂系统,专为芯片贴装应用而设计,需要加热固化:Supreme 3HTND-2DA、EP3HTS-TC、EP3HTSDA-2、EP17HTDA-1 和 EP17HTDA-2。使用大约 2 x 2 mm (80 x 80 mil) 的模具尺寸,根据其规格涂覆和固化粘合剂。模具剪切试验的结果如下图所示。
模具剪切强度测试结果

具有高模具剪切强度的胶粘剂
 |
Supreme 3HTND-2DA
单组份,快速固化的芯片粘接胶粘剂。优异的模具剪切强度。工作温度范围为 -100°F 至 +400°F。 低离子。优异的导热性和电绝缘性能。分配顺畅,不会拖尾或渗出。在 150°C 下 5-10 分钟内固化。 NASA 低释气批准。提供注射器。非常适合自动点胶。在 85°C/85% RH 测试中表现良好。 |
 |
EP3HTS-TC
银填充导电,用于芯片贴装和一般键合。体积电阻率低,耐高温。卓越的粘接强度。导热性。触变性糊状物,稠度好。可用于与各种类型的自动分配器或手动分配器兼容的注射器。工作温度范围为 -80°F 至 +400°F。 |
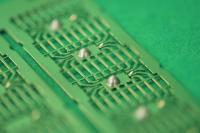 |
EP3HTSDA-2
银填充导电环氧树脂具有快速的固化速度。体积电阻率低,耐高温。卓越的粘接强度。导热性强,热阻极低。膏体光滑,一致性好。可用于与各种类型的自动分配器或手动分配器兼容的注射器。工作温度范围为 -80°F 至 +450°F。 |
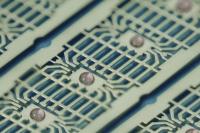 |
EP17HTDA-1单组分热固化环氧树脂胶粘剂/密封剂。无滴漏系统。可抵抗高达 525°F。 符合 NASA 低释气规范。符合 MIL-STD-883J 第 3.5.2 节的热稳定性要求。高搭接剪切力、抗拉强度和抗压强度。后固化后 Tg 为 230-240°C。 |
 |
EP17HTDA-2单组分,热固化环氧树脂,用于粘接和密封,以及芯片贴装应用。可流动的高粘度系统,在 300°F 下固化 4-5 小时,在 350°F 下固化 3-4 小时。 后固化以优化性能。玻璃化转变温度高。美国国家航空航天局(NASA)批准低释气。 |
询价采购美国 MasterBond 高模具剪切强度胶水 Supreme 3HTND-2DA EP3HTS-TC EP3HTSDA-2 EP17HTDA-1 EP17HTDA-2
请用微信扫描下方二维码或手动添加微信号2351992198